M1301
集束イオンビーム加工観察装置(FIB)
Focused Ion Beam System
1. メーカー・型式
日本電子製 JIB-4000
2. 特徴
高性能イオンカラムを搭載しており、最大電流値60nAのイオンビームによる、高速で広い領域の断面加工が可能です。
3. 原理、概念図
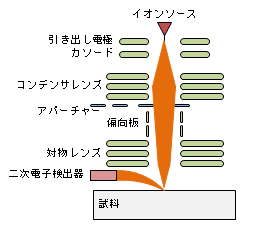
図1:概念図
- 1〜30kVで加速されたGaイオンを細く絞り、試料上を走査することにより、特定箇所のFIB加工を行います。
- 試料から発生する二次電子を検出することにより走査イオン像(SIM像)の観察を行います。
4. 性能と仕様
- 加速電圧:1〜30kV 分解能5nm
- 付属装置:ガス供給システム(C、Pt)、SEM共用ホルダ
5. 試料の形状、サイズ
固体、外径20mmφ以内、高さ23mm以内
6. 分析依頼時の留意点
真空中でGaイオンを照射します。その条件下で試料が安定である必要があります。
7. 測定データ例
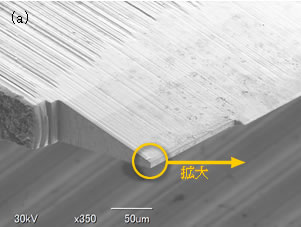 |
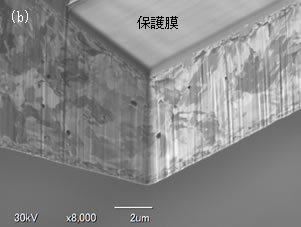 |
図2 トリミングナイフ先端 |
|
 |
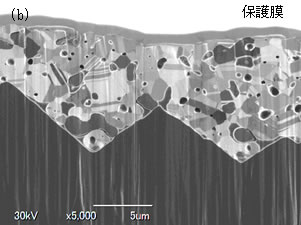 |
図3 太陽電池配線部 |
|
8. 適用例
- 半導体配線の断面観察
- 金属結晶方位の観察
- フィルター細孔の断面観察




















