M1602
球面収差補正STEM
当社は、従来より低加速電圧測定および高感度EDS分析を可能にした球面収差補正STEMを導入し、2016年10月より材料解析を開始しました。
1. メーカー・型式
日本電子製 JEM-ARM200F
2. 特徴
- 200kVから30kVの低加速電圧まで設定可能であり、電子線ダメージ(ドリリング、非晶質化、欠陥の導入、原子のはじきだし等)対策に有効です。
- 低加速電圧まで対応可能な電子源と球面収差補正装置を搭載することにより、低加速で高いSTEM分解能を得ることができます。
- 従来より明るく細い電子プローブは像観察だけでなく、元素分析時の信号量増加により定量性の向上と微量元素の検出に有利となります。
- 大面積100mm2シリコンドリフト検出器SDDを搭載することにより、従来比約7倍の高感度かつ高速EDS分析が可能となりました。
3. データ例
- TiSi2(図1)
- シリコン(図2)
- コアシェルナノ粒子(図3)

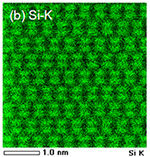
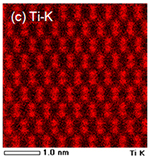
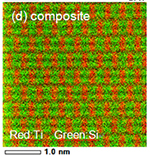
図1:TiSi2の(a)暗視野STEM像、(b)Si-K像、(c)Ti-K像、(d)合成像(加速電圧:120kV)
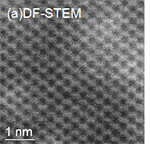

図2:シリコン<110>の(a)暗視野STEM像、(b)FFTパターン(加速電圧:30kV)
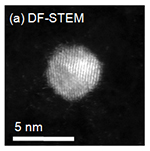
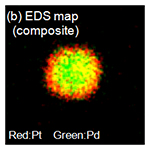
図3:コアシェルナノ粒子の(a)暗視野STEM像、(b)EDSマップ(赤:Pt、緑:Pd)(加速電圧:120kV)
4. 適用例
- ナノ粒子における原子配列、組成分布解析
- 半導体材料・セラミックス・金属の表面、粒界、欠陥、界面等の解析




















