S252
SIM像によるチャネリングコントラスト
集束イオンビーム(FIB:Focused Ion Beam)装置の機能の一つに、走査イオン(SIM:Scanning Ion Microscopy)像があります。試料表面をGaイオンビームで走査して放出される二次電子を検出することにより像が得られます。
このSIM像では、チャネリングコントラスト、すなわち金属組織の結晶方位の違いによるコントラストが明瞭に観察できます。
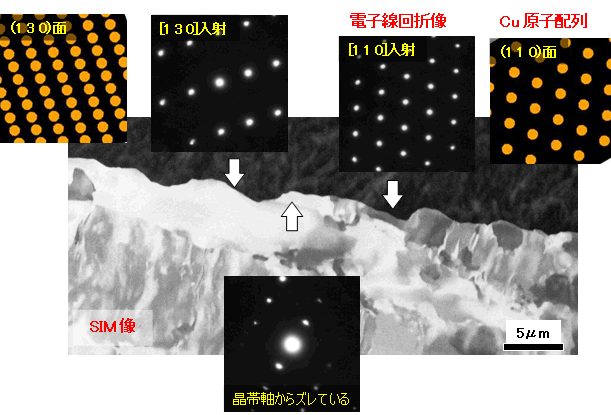
Cu金属のTEM試料をSIMにより観察すると、チャネリング現象による白黒のコントラストが見られます。矢印部のTEMによる電子線回折像を測定すると、[110]入射(黒い箇所)と[130]入射(白い箇所)の回折像が得られました。
回折像からCuの原子配列を求めると、それぞれオレンジ色の配列となります。原子コラムの間隔の広い結晶面では、照射されたGaイオンが隙間に深く入り込み、そこで発生した二次電子は試料の外へ放出されるのが困難になります。その結果、二次電子の収量が減少し、コントラストの低下が起こるのです。[130]面の箇所に比べて[110]面の箇所が暗いのはこのためです。






















