S438
Cs補正STEMによる各種材料観察
Cs補正STEMは電子レンズの球面収差補正によりビームを0.1nm程度と非常に細く絞ることができます。これを走査して試料を透過散乱した電子を検出するHAADF-STEM(参考資料:高分解能HAADF-STEM像)では、原子カラムの並びを直視する像を得ることができます。各種材料のHAADF-STEM像を図1に示します。
| (a) | アルミニウム [110]入射 |
| (b) | ガリウム砒素 [110]入射 |
| (c) | 窒化シリコン [0001]入射 |
| (d) | 炭化シリコン [11-20]入射 |
| (e) | 炭化チタン粒界 [100]入射 |
| (f) | チタンシリサイド/シリコン界面 シリコン[110]入射 |
単結晶領域(a〜d)、粒界(e)や界面(f)の観察に有効です。
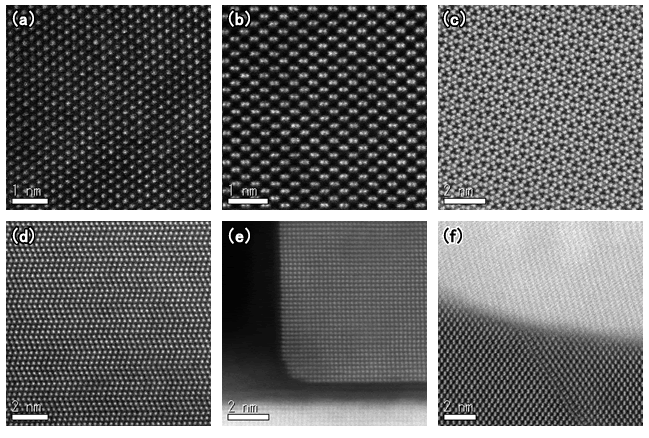
図1:各種材料のHAADF-STEM像
(a) Al、(b) GaAs、(c) Si3N4、(d) SiC、(e) TiC、(f) Ti-Si/Si























