X118
X線反射率による多層膜の膜厚、密度、表面(界面)粗さ評価
X線の屈折・反射の現象を利用した分析手法にX線反射率測定があります。この方法は、X線の反射率が物質の密度などと関係していることを利用して、反射率の入射角度依存性を測定し、そこから膜厚、密度、界面粗さなどの膜構造パラメータを決定するという方法です。実際には、測定して得られた反射率プロファイルの特徴と構造パラメータの関係を考慮しながら、測定反射率(青い点)と計算反射率(赤い線)が一致するように、膜厚、密度、界面粗さなどを最小二乗法解析によって精密化することになります。
| 試料 | 多層薄膜 |
|---|---|
| 装置 | 理学電機製 ATX-G型 表面構造評価用 多機能X線回折装置 |
解析例を下図に示します。本分析では、各層の膜厚、密度、界面粗さの情報が得られ、表面酸化層の確認、主層1の理論密度5.47g/cm3と遜色ない解析結果が得られました。
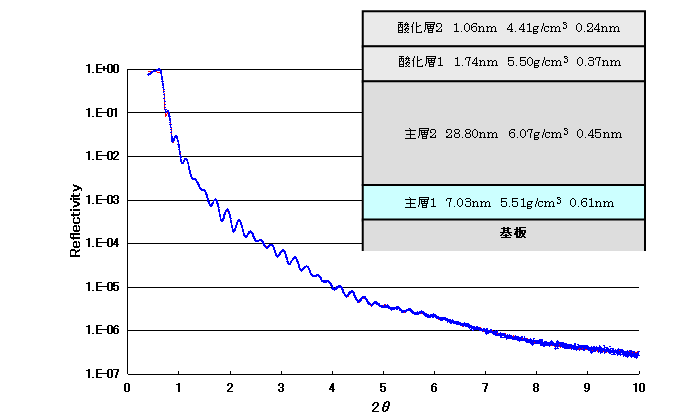
図:多層薄膜の反射率解析プロファイル
























