O293
TOF-SIMSによる残存シラノールの分析
ガラス基板やシリコンウエハ上に残存するシラノール量は、含臭素ケイ素化合物で処理し、TOF-SIMS測定を行うことにより調べることができます。
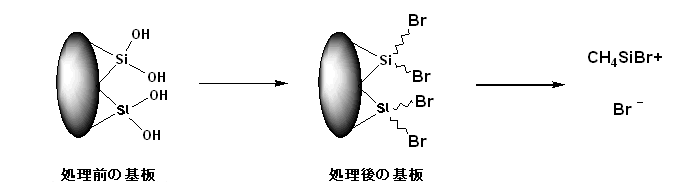

測定の結果得られた2種類のイオン種について次式により、規格化2次イオン検出強度を算出します。
| 規格化2次イオン検出強度 = | ターゲットイオンのカウント数 | ×103 |
| トータルイオンのカウント数 |
水の弾きが悪い試料(2)の2次イオン質量スペクトルを図1(CH4SiBr+イオン)と図2(Br-)に、また試料(1)、(2)のデータ処理結果を図3に示しました。
図3から試料間で残存シラノール量に顕著な差が認められ、試料(1)と比較して試料(2)の方がOH基の多いことが推察されます。また、2ポイントずつの測定におけるバラツキも小さいことが分かります。
この方法は残存するシラノールの絶対量は算出できませんが、相対比較により試料間の差異を調べることができます。

図1:2次イオン質量スペクトル(CH4SiBr+m/z=123)

図2:2次イオン質量スペクトル(Br-m/z=79)

図3:規格化2次イオン検出強度(バーグラフ)
























