S0503
クロスセクションポリッシャ(CP)
1. 型式
日本電子(株)製 クロスセクションポリッシャ:SM-09010、SM-09020
2. 原理・概略図
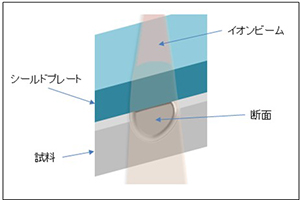
CP加工の概要図
- 真空中で、試料にイオンビームを照射するとエッチングにより穿孔されるが、試料表面にシールドプレートを設置することにより、シールドプレートの下にイオン加工された断面が形成される。この断面は、機械的なダメージのない断面であり、従来の機械研磨では変形してしまうような構造も、忠実に断面作製ができる。
- 機械研磨では、鏡面研磨が困難な軟質金属や、それらを含む硬軟複合材料、またダイヤモンド粒子などの超硬質材料の断面加工も可能。
- Arイオンを用いた加工であり、Gaイオンを用いるFIB加工に比べて、低ダメージでの加工が可能。また、広範囲(〜500μm巾程度)の断面作製が可能。
3. 性能、仕様
| 加工イオン | アルゴン |
|---|---|
| イオン加速電圧 | 3〜6kV |
| 加工速度 | 1.3μm/min(加速電圧6kV、SiO2換算) |
| 断面位置決め精度 | 10〜20μm程度(光学顕微鏡による位置決め) |
| オプション | 回転試料ホルダ |
4. 試料形状、サイズ
| 形状 | 11mmW×10mmL×2mmH以下 |
|---|---|
| 加工 | 樹脂包埋、機械研磨などを併用して、所定位置付近(25〜50μm程度)での粗断面を作製後、CP法による仕上げ断面加工 |
| 性状 | 試料作製時に、水・有機溶媒や各種樹脂等を使用するため、耐熱性、吸湿性、耐薬品性等の情報が必要 |
5. 適用分野
- 各種基板(FPC、セラミックス、ガラスエポキシなど)の断面作製
- 電子部品(発光ダイオードなど)の断面作製
- ダイヤモンド/SiC研磨シート、砥石の断面作製
- 樹脂粉末の断面作製
- セラミックス繊維の断面作製




















