S182
オージェによる異物断面の分析
半導体の製造プロセスでは、様々な原因でウエハやデバイスに欠陥が発生し、製品の歩留まり低下を引き起こします。近年、デバイスの集積化が急速に進んでいますが、集積化が進むにつれ、微小な粒子による欠陥が大きな問題となっています。ここでは、ウエハチップの内部に見られた異物をFIB(Focused ion beam)で加工して、異物の断面を作製後、オージェ分析した例を示します。
図1はポリシリコン膜内部にみられた異物を分析したもので、オージェスペクトルならびにマッピングより異物はシリコン酸化物であることが分かります。図2は配線内に見られた異常部で、SUS系の異物が見られています。
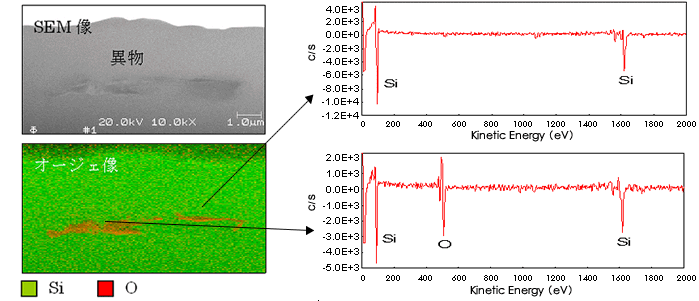
図1:ポリシリコン内部の異物

図2:配線内部の異物























