S264
SPMによるSiウエハの表面粗さ測定
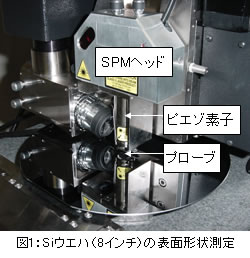
NanoScope走査型プローブ顕微鏡(D3100型)は150mmφの大型サンプルステージを有し、試料ステージに試料を真空チャックで固定することにより、図1のように、最大では8インチウエハの表面形状を非破壊で観察することができます。測定時には、試料はステージに確実に固定され、SPMヘッド下部先端のプローブをピエゾ素子の電圧制御で動かすことによって、試料表面の形状測定(最大測定エリア:90×90μm)が行われます。また、本装置では、タッピングモードでの測定が可能で、さまざまな試料表面の高分解能イメージが得られます。
図2にSiウエハ表面形状と表面粗さ解析結果を示します。各表面粗さパラメータは下記の式で定義された値です。(N:データポイント数、Zi:各データポイントのZの値、Zave:全Z値の平均値)
| Img. Rms(Rq) | : | 全Z軸データの標準偏差 Rms={Σ(Zi−Zave)2/N}1/2 |
| Img. Ra | : | 中心面に対する平均粗さ Ra=Σ|Zi−Zave|/N |
| Img. Rmax | : | 平均面に対してのZ軸の最高値と最低値の差 |
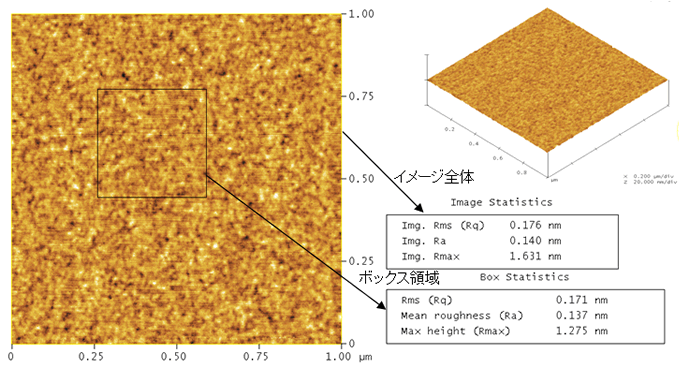
図2:Siウエハの表面形状および表面粗さパラメータ計算結果























