S420
EDS制限視野マッピング測定
従来、EDSマッピングでは、SEMで観察した領域の元素分布を測定することが通例でしたが、最近のEDS分析ソフトでは、視野中の任意領域でのマッピング(制限視野マッピング)測定が可能になっています。
図1に制限視野マッピングの測定例を示します。LSIパッケージ表面の顔料インクで描かれた文字を観察しました。視野中には、アルファベットで3文字が描かれており、いずれも同じ構造と考えられます。このような場合、観察視野全面ではなく、代表的な部分をマッピングすることで、必要十分な情報を得ることができます。
パッケージ樹脂はSiを含んでおり、顔料インクはTiO2を含んでいるため、SiとTiの分布で、パッケージ樹脂の部分と文字部分が区別されます。さらに、パッケージの表面には、Naを含む汚れの付着が確認されました。
制限視野マッピングでは、狭い領域をマッピングするため、短時間で高S/N比の結果を得ることができます。したがって、従来のマッピングでは長時間を要していた高画素数のマッピングを容易に行うことができます。図1の測定ではマップの画素数を増やした高解像度でのマッピング測定を行った結果、パッケージ表面のNa汚染状態を明瞭に観察出来るようになりました。
この制限視野マッピングは、任意の形状で測定領域を指定できるため、例えば皮膜や層状構造物の断面分析など、アスペクト比の極端に大きな領域に注目する分析などで、有効な手法となります。
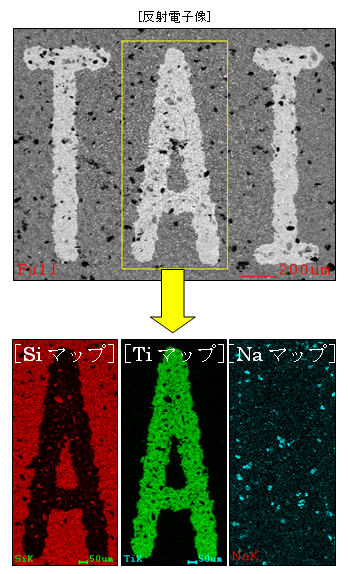
図1:制限視野マッピングの測定例






















