S442
原子間力顕微鏡(AFM)によるエッチング段差測定
走査型プローブ顕微鏡(SPM)のモードの1つである原子間力顕微鏡(AFM)の用途として、試料表面にドライエッチング等で作製した段差を測定・解析することが可能です。得られた結果は、試料表面のドライエッチングレート測定などに役立てることができます。
まず、試料表面をマスキング(図1の左上側および図2の左側)して、エッチングされないように致します。その後、ドライエッチング等を行い、試料を作製いたします。試料表面からマスキングを剥がして、作製されたエッチング段差部分のAFM観察を行います。
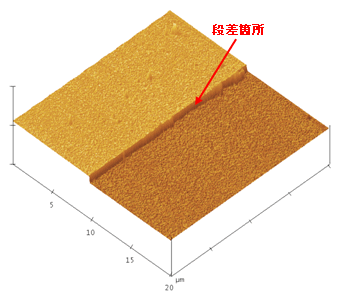
図1:エッチング段差の形状イメージ
図1に示したのが、作製された試料表面の段差部分の鳥瞰図です。マスクされた箇所(図中左上側)はエッチングされずに、エッチングされた箇所(図中右下側)より1段高くなっており、明確な段差ができた状態であることが分かります。
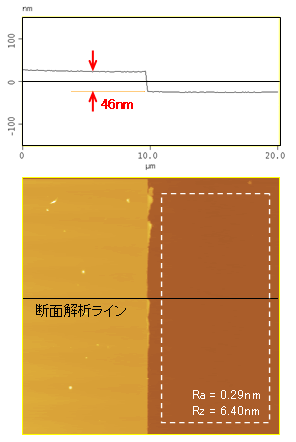
図2:エッチング段差の断面解析
図2には、断面解析を行い、エッチング段差の高さの測定結果を示しました。図中に黒線で示した断面解析ラインでの断面の様子が上に示しました断面解析結果です。得られた結果から、作製されたエッチング段差は46nmであると求められました。また、エッチング箇所の白点線枠内では、平均粗さ(Ra)が0.29nm、最大高低差(Rz)も6.40nmと非常に平坦な状態であることが分かりました。
以上ように、エッチング段差等のナノオーダーといった非常に小さな段差測定にも、原子間力顕微鏡(AFM)は活躍いたします。























