X115
多孔質low-k膜ポアサイズ分布解析
シリコンプロセスで開発が急がれている層間絶縁膜の低誘電率化に導入される多孔質low-k材料について、その重要な特性であるポアサイズとその分布を評価する新しい手法・反射X線小角散乱法の実施例を紹介します。
径が1〜100nm程度の微細なポアにX線が入射しますと、周囲と密度が異なるためにポアは散乱体として働き散漫散乱を生じます。この散乱強度の角度依存は、ポアサイズとその分布状態に依存しており、球状モデルとΓ分布を仮定した散乱X線強度式により散乱プロファイルをフィッティングして解析することができます。
| 試料 | 多孔質low-k材料 |
|---|---|
| 装置 | 理学電機製 ATX-G型 表面構造評価用 多機能X線回折装置 |
左図は反射X線がlow-k膜中のポアとその分布により生じた散漫散乱の測定データ(赤)を球状モデルとΓ分布を仮定した理論散乱X線強度式によりプロファイルフィッティング(青)した結果です。右図は、この解析結果よりポアサイズ分布を求めた結果で、平均空孔直径は5.1nm、最大分布空孔直径は3.8nmとなりました。
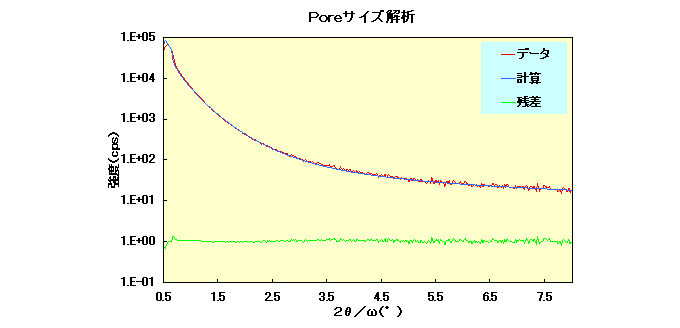
図1:ポアサイズ解析チャート
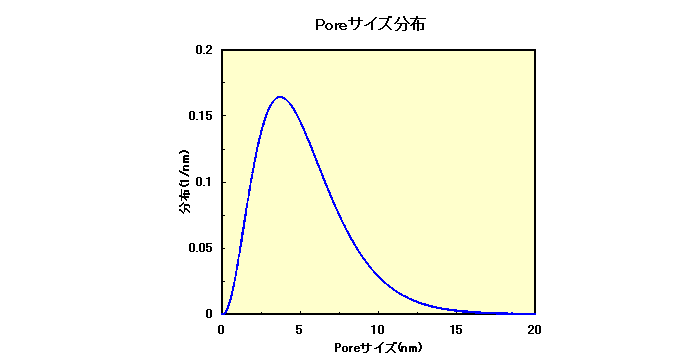
図2:ポアサイズ分布図






















