M255
FIB-TEM法を用いたコーティング膜(表面処理膜)の分析
多くの製品の表面には、性能向上(硬度、耐摩耗性、耐腐食性、耐酸化性など)を目的とし、様々なコーティング(表面処理)が施されています。コーティングの組織構造は微細で、ナノメートルオーダーの評価を必要とする製品も多く存在します。以下に、収束イオンビーム(FIB:Focused Ion Beam)装置と透過電子顕微鏡(TEM:Transmission Electron Microscope)を用いたコーティングの評価事例を紹介します。
Siウエハ表面に成膜した模擬コーティング膜の断面明視野STEM(Scanning Transmission Electron Microscope)像、断面暗視野STEM像、EDS(Energy dispersive X-ray spectroscopy)マッピング分析結果を図1、図2、図3に示します。本結果から、コーティング膜の層構造(図1、図2)、膜厚(表)、組成(図3)、結晶性*について評価することが可能です。これらの情報は、製品開発において、有益な情報となることが期待されます。
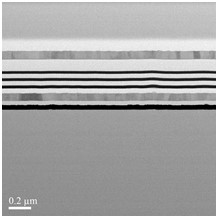
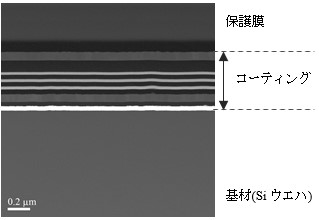


*電子回折パターンより解析(技術資料「電子回折法による土壌鉱物の同定」、「電子回折および高速フーリエ変換(FFT)パターンについて」参照)























