M261
FIB法を用いたAl薄膜の断面、平面TEM分析
収束イオンビーム(FIB:Focused Ion Beam)法*1は透過電子顕微鏡(TEM:Transmission Electron Microscope)の前処理法として広く用いられており、指定領域の断面および平面TEM試料を精度良く作製することが可能です。今回、Siウエハ表面に成膜したAl薄膜の組織構造を評価するため、FIB法を用いて断面、平面TEM分析を行いましたので、以下に紹介します。
Al薄膜の断面TEM像を図1、図2(拡大像)に示します。同視野のEDS(Energy dispersive X-ray spectroscopy)元素マッピングを図3に示します。Siウエハ表面に膜厚が150nm程度のAl薄膜が確認され、二層構造を有していることが分かります。また、層1および層2表面はOリッチであることが示唆されました。次に、Al薄膜(層2)の平面TEM像を図4に、粒子径解析結果を図5に示します。Al薄膜(層2)の結晶粒子径は33〜244nm程度であり、断面、平面TEM像より柱状結晶であることが分かりました。このように、断面、平面TEM分析を行うことにより、材料の組織構造をより詳細に把握することが可能となります。
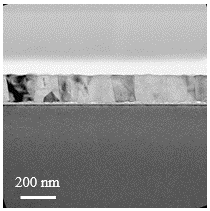
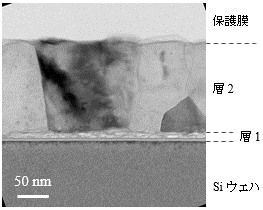
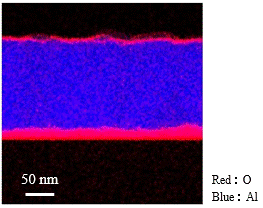


(左)平面TEM像+粒界

*1 技術資料「透過型電子顕微鏡試料作製:FIB法」
























