S309
走査型プローブ顕微鏡
−パワースペクトル密度による表面形状評価−
表面形状の異なる2種類の試料表面をタッピングモード原子間力顕微鏡(AFM)で測定した結果を図1に示した。
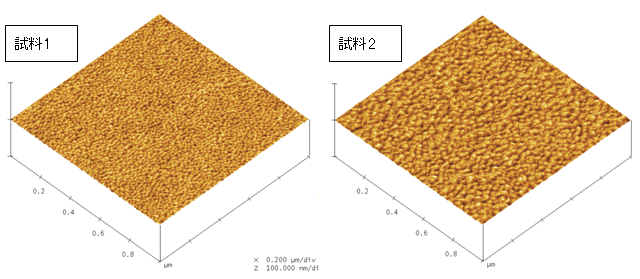
図1:タッピングモード原子間力顕微鏡で測定した試料1、2の表面形状
両試料の表面粗さは、通常よく用いられる二乗平均粗さ(Rms)や平均粗さ(Ra)で比較すると、表1のように、ほぼ同等の値であることが分かる。しかし、図1から明らかなように、両者の表面形状には凹凸のスケールに違いが認められる。この違いを定量化するために、二次元パワースペクトル密度(Power Spectral Density)の評価を行った例を図2に示した。パワースペクトルは、オリジナルの波形を高速フーリエ変換して、各波長の構成波形成分に分離して求められる。ここでは、二次元のフーリエ変換によって求められた二次元等方性パワースペクトル密度(2D isotropic PSD)によって、両試料表面形状を比較した。図2のように、試料(1)では20〜40nmの周期成分が優勢であるのに対して、試料(2)では40〜100nmの周期成分が支配的であることが分かる。
| Rms (nm) | Ra (nm) | Rmax (nm) | |
|---|---|---|---|
| 試料1 | 0.59 | 0.48 | 4.55 |
| 試料2 | 0.60 | 0.47 | 5.00 |
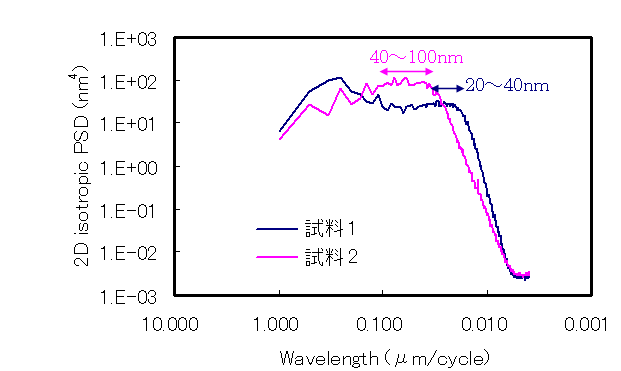
図2:二次元パワースペクトル密度の評価























