M257
FIB-SEM法を用いたSiウエハ上異物の分析
収束イオンビーム(FIB:Focused Ion Beam)装置と走査電子顕微鏡(SEM:Scanning Electron Microscope)を用いることにより、Siウエハ上に発生した異物の形状、組成を評価することができます。以下に粒状異物の評価事例を紹介します。
Siウエハ上の模擬異物の表面SEM像(反射電子像)を図1に示します。次に、異物の断面SEM像(反射電子像)*1、EDS(energy dispersive X-ray spectroscopy)スペクトルを図2、図3に示します。得られた情報より、Siウエハ上の異物は大きさが30µm程度の多孔質なFe-O粒子であることが分かりました。これらの情報は異物の混入源や混入経路を特定することに役立つため、製品の品質向上、歩留まり向上に繋がることが期待されます。

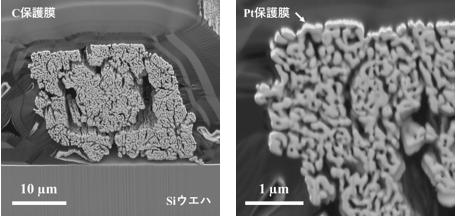

*1 試料を45°傾斜して観察(図2は傾斜補正像)
備考:EBSD分析の対応も可能です。技術資料M204をご参照下さい。























